Sistem Pengukuran Ellipse










Gambaran Keseluruhan Produk
Berdasarkan modulasi pemampas putaran berganda, pengukuran pantas 16 elemen keseluruhan matriks Muller direalisasikan
Ia digunakan untuk pencirian ketebalan filem nipis isotropik/anisotropik, pemalar optik, dan struktur nano.
Teknologi teras
- Teknologi kawalan segerak pemampas putaran dwi
- Teknologi pemampas akromatik spektrum luas,
- Teknologi pengesanan bintik rendah Algoritma penentukuran ketepatan instrumen
- Perubahan sudut automatik sepenuhnya dan teknologi fokus, pengukuran pantas satu kunci
- Permukaan buah mesin manusia interaktif Wizard, pengalaman operasi perisian yang mudah
- Pangkalan data bahan yang banyak dan perpustakaan model algoritma, keupayaan analisis data yang kuat


Technical Characteristics






Mapping
Spectral Ellipsometry Solution
It meets the needs of multi-point custom mapping of large-size substrates, supports size customization, real-time offline detection and output of film thickness morphology distribution and data reports, and is widely used in equipment manufacturers/Fab-level coating uniformity rapid measurement and characterization

High-Precision Spectroscopic Ellipsometer
It can realize scientific research/enterprise-level high-precision and rapid spectral ellipsometry measurement, support multi-angle, low-spot and other high-compatibility flexible configuration, multi-function module customized design, and is widely used in optical communication/OLED/TP/transparent conductive film and other applications involving transparent substrate coating measurement and characterization

Spectral Ellipsometry Solution for Micro
With the image recognition system, it can meet the needs of high-precision and fast spectral ellipsometry measurement of various micro-regions of various objects to be measured at the scientific research/enterprise level
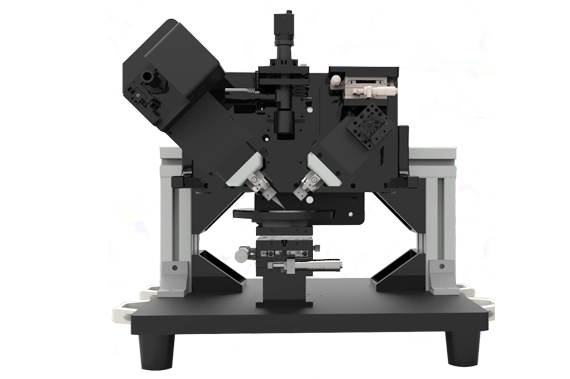
Economical Spectral Ellipsomemeter solution
It can meet the cost-effective measurement needs of most of the spectral ellipses of scientific research/enterprise films, quickly characterize the thickness and optical constants of thin films, and can achieve one-click measurement for conventional single-throw Si/InP/GaAs and other substrate coatings

Mapping
Spectral Ellipsometry Solution
It meets the needs of multi-point custom mapping of large-size substrates, supports size customization, real-time offline detection and output of film thickness morphology distribution and data reports, and is widely used in equipment manufacturers/Fab-level coating uniformity rapid measurement and characterization

High-Precision Spectroscopic Ellipsometer
It can realize scientific research/enterprise-level high-precision and rapid spectral ellipsometry measurement, support multi-angle, low-spot and other high-compatibility flexible configuration, multi-function module customized design, and is widely used in optical communication/OLED/TP/transparent conductive film and other applications involving transparent substrate coating measurement and characterization

Spectral Ellipsometry Solution for Micro
With the image recognition system, it can meet the needs of high-precision and fast spectral ellipsometry measurement of various micro-regions of various objects to be measured at the scientific research/enterprise level
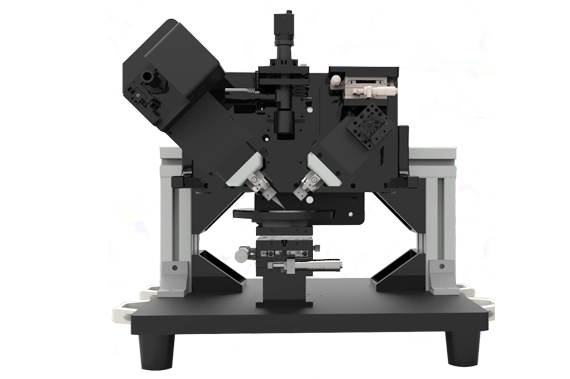
Economical Spectral Ellipsomemeter solution
It can meet the cost-effective measurement needs of most of the spectral ellipses of scientific research/enterprise films, quickly characterize the thickness and optical constants of thin films, and can achieve one-click measurement for conventional single-throw Si/InP/GaAs and other substrate coatings

Mapping
Spectral Ellipsometry Solution
It meets the needs of multi-point custom mapping of large-size substrates, supports size customization, real-time offline detection and output of film thickness morphology distribution and data reports, and is widely used in equipment manufacturers/Fab-level coating uniformity rapid measurement and characterization


Technical Specifications:


- Home Home
- About Us About Us
- All Products All Products
- Fabs Fabs
- Labs Labs
- Courses Courses
- Services Services
- Application Application
- Accessories Accessories
- Vibration Isolator Vibration Isolator
- UV ozone UV ozone
- News & Events News & Events
- Contact Us Contact Us
- Request Quotation Request Quotation
- Insitu AFM SEM Insitu AFM SEM





